Процессы обработки подложек SiC следующие:
1. Ориентация кристалла:
Использование дифракции рентгеновских лучей для ориентации кристаллического слитка. Когда рентгеновский луч направляется на нужную грань кристалла, угол дифрагированного луча определяет ориентацию кристалла.
2. Шлифование наружного диаметра:
Монокристаллы, выращенные в графитовых тиглях, часто превышают стандартный диаметр. Шлифование наружного диаметра приводит их к стандартным размерам.
3. Шлифование торцевой поверхности:
4-дюймовые подложки из 4H-SiC обычно имеют две позиционирующие кромки: первичную и вторичную. Торцевая шлифовка открывает эти позиционирующие кромки.
4. Проволочная пила:
Распиловка проволокой является важным этапом обработки подложек 4H-SiC. Трещины и повреждения подповерхностной поверхности, возникающие во время распиловки проволокой, негативно влияют на последующие процессы, увеличивая время обработки и вызывая потери материала. Самый распространенный метод – многопроволочная пилка алмазным абразивом. Для резки слитка 4H-SiC используется возвратно-поступательное движение металлических проволок, связанных алмазными абразивами.
5. Снятие фасок:
Чтобы предотвратить сколы кромок и уменьшить потери расходных материалов во время последующих процессов, на острых кромках стружки, распиленной проволокой, снимаются фаски до заданной формы.
6. Истончение:
Распиловка проволокой оставляет множество царапин и подповерхностных повреждений. Утончение производится с помощью алмазных кругов, чтобы максимально устранить эти дефекты.
7. Шлифование:
Этот процесс включает в себя черновое и тонкое шлифование с использованием карбида бора или алмазных абразивов меньшего размера для удаления остаточных повреждений и новых повреждений, возникших при утончении.
8. Полировка:
Заключительные этапы включают грубую и тонкую полировку с использованием абразивов из оксида алюминия или оксида кремния. Полирующая жидкость смягчает поверхность, которая затем механически удаляется абразивами. Этот шаг обеспечивает гладкую и неповрежденную поверхность.
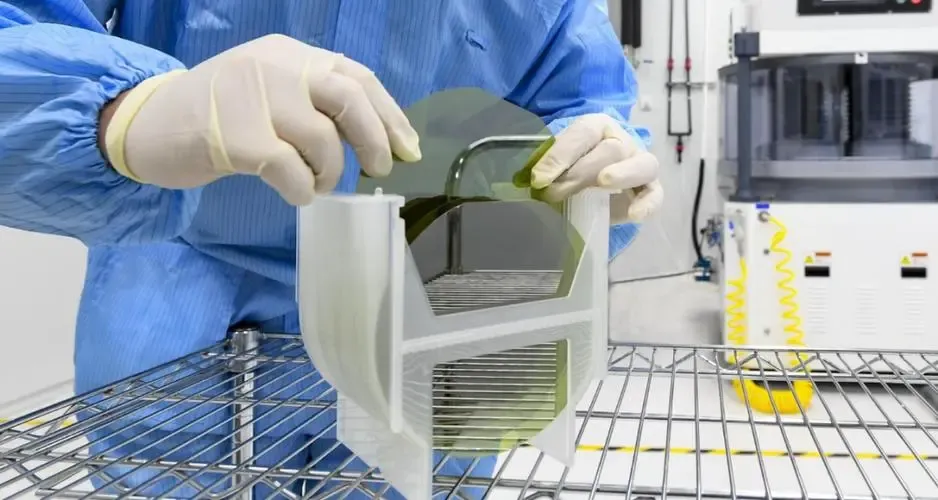
9. Очистка:
Удаление частиц, металлов, оксидных пленок, органических остатков и других загрязнений, оставшихся после этапов обработки.
Время публикации: 15 мая 2024 г.